在半导体器件的研发与生产中,材料内部的“完美”与“缺陷”是决定其性能优劣的核心。无论是光电二极管、晶体管,还是CCD与CMOS图像传感器,其正向反向电流特性、噪声水平、少数载流子寿命乃至电荷存储时间,都深受一类“隐形杀手”——深能级(Deep Levels)的严重影响。要精确、全面地捕获这些深能级或陷阱的参数信息,深度能级瞬态谱(DLTS, Deep Level Transient Spectroscopy)技术是公认的灵敏度最高的分析手段之一。
从能带理论来看,施主、受主这些浅能级与所谓的深能级、陷阱,在描述上并无本质区别。它们都是禁带中的局域态。关键的差异在于其能量位置:施主和受主能级非常贴近导带底或价带顶(通常在几十meV范围内),而深能级或陷阱则更靠近禁带中央,其能量深度通常大于200meV。
尽管描述深、浅能级电离的物理方程是通用的,但“深能级”和“陷阱”在行为上却有微妙而重要的区别,这主要源于它们与导带、价带相互作用速率的差异。
在肖特基二极管的耗尽区内,这种由深能级和陷阱充放电引起的总电荷(电离掺杂原子+深能级电荷)随时间的变化,会直接改变空间电荷区的电容。通过测量电容随时间的变化,我们就能反过来监测陷阱的再充电过程。这门技术被称为电容谱学,而DLTS正是其最精细化的应用。
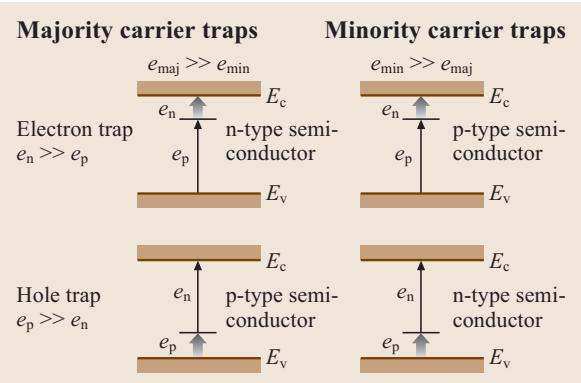 图1 n型和p型半导体中,多数载流子陷阱与少数载流子陷阱的能级位置及其主要相互作用路径示意图
图1 n型和p型半导体中,多数载流子陷阱与少数载流子陷阱的能级位置及其主要相互作用路径示意图
如图1所示,陷阱根据其主要相互作用的能带进行分类。如果一个陷阱能级离导带更近(如图中上部的电子陷阱),其电子发射率en就会远大于空穴发射率ep。反之,靠近价带的陷阱则为空穴陷阱。与多数(少数)载流子带主要作用的陷阱,被称为多数(少数)载流子陷阱。
表征一个陷阱,我们需要掌握以下几个核心参数:
载流子被陷阱捕获是一个极快的过程,其捕获率 cn 和 cp (单位: s-1) 可由下式描述: $$ c_n = /sigma_n v_{th} n /quad /text{and} /quad c_p = /sigma_p v_{th} p /tag{1} $$ 其中,vth 是载流子热运动速率 (约107 cm/s),n 和 p 分别是相应能带中的载流子浓度。
捕获之后是发射。对于一个电子陷阱,其电子发射率 en (单位: s-1) 由其激活能决定,并呈指数关系: $$ e_n = /sigma_n v_{th} N_c g /exp /left(-/frac{E_c - E_T}{k_b T}/right) /tag{2} $$ 这个方程是构建阿伦尼乌斯图(Arrhenius Plot)的理论基础。通过绘制 log(eg/T2) 对 1000/T 的关系图,我们就能从斜率中提取陷阱的激活能。式中 T2 的前置因子,源于有效态密度 Nc 和热运动速率 vth 的综合温度依赖性。
根据Shockley-Read-Hall (SRH) 理论,少数载流子有效寿命 τeff (s) 可以通过陷阱参数计算产生率 U (cm-3s-1) 来推导: $$ /tau_{eff} = /frac{n_i}{U} /tag{3} $$ 其中 ni 是半导体的本征载流子浓度,而产生率 U 为: $$ U = /frac{/sigma_p /sigma_n v_{th} N_T}{/sigma_n /exp/left(/frac{E_{trap}}{k_B T}/right) + /sigma_p /exp/left(/frac{-E_{trap}}{k_B T}/right)} n_i /tag{4} $$ 这里的 Etrap 是陷阱能级相对于本征费米能级 Ei 的位置。从式(4)可以看出,能量位置靠近禁带中部的深能级,其产生-复合率 U 最大,从而导致最低的少数载流子寿命。因此,精确测定 NT, ET, σn, σp 这些陷阱参数,是半导体材料质量评估与器件性能预测的关键任务。
DLTS技术的核心操作,在于对肖特基二极管或pn结施加周期性的偏压脉冲。具体来说,先施加一个短暂(微秒级)的弱正向偏压脉冲(陷阱填充阶段),紧接着切换到一个持续时间长得多(毫秒至秒级)的深度反向偏压(陷阱发射阶段),并在此期间观察电容的瞬态变化。这个过程在77K到400K的宽温区内重复进行,并对微弱的电容瞬态信号进行累加平均,从而极大地提高了信噪比。
 图2 一个类施主多数载流子陷阱在填充阶段(2)和发射阶段(3)的电容瞬态响应
图2 一个类施主多数载流子陷阱在填充阶段(2)和发射阶段(3)的电容瞬态响应
图2展示了一个典型的多数载流子陷阱(一个类施主陷阱,占据电子时呈中性,失去电子后呈正电性)的电容瞬态过程。
在发射阶段,电容随时间的变化 C(t) 可以用下式描述: $$ C(t) = A/sqrt{/frac{q/epsilon_0/epsilon_r}{2(V_{bi} + V_r)}/left/{N_D^+ + N_T/left[1 - /exp(-e_n t)/right]/right/}} $$ 当发射过程结束 (t→∞),所有陷阱都变为空穴(带正电),对空间电荷的贡献达到最大,电容也达到稳定值 C∞。电容的总变化量 ΔCtot = C∞ - C0 的幅度,正比于陷阱浓度 NT。
然而,在实际应用中,陷阱浓度往往比浅掺杂浓度低好几个数量级,导致ΔCtot 极其微弱,完全淹没在测量噪声中。1974年,D. V. Lang 提出了一种天才的方法,即DLTS技术,它能从噪声中“捞出”信噪比极低的电容瞬态信号。
其精髓有两点:
 图3 DLTS信号构建原理:通过在(t2-t1)观测窗口内测量不同温度下的电容瞬态,构建DLTS信号峰
图3 DLTS信号构建原理:通过在(t2-t1)观测窗口内测量不同温度下的电容瞬态,构建DLTS信号峰
如图3所示,通过扫描温度,当某个特定温度下陷阱的发射率正好与设定的速率窗匹配时,观测到的电容差 C(t1) - C(t2) 会出现一个峰值。在低温下,发射太慢,窗口内电容几乎不变;在高温下,发射太快,在t1时刻前就已完成。通过改变速率窗的设置并重复扫描温度,就可以得到一系列DLTS峰。
 图4 n型硅中Au施主陷阱的典型DLTS测量图谱。随着速率窗(rw)增大,DLTS峰向高温方向移动。
图4 n型硅中Au施主陷阱的典型DLTS测量图谱。随着速率窗(rw)增大,DLTS峰向高温方向移动。
图4展示了n型硅中Au陷阱的DLTS图谱。可以看到,随着速率窗设置的增加(对应更慢的发射率),DLTS峰出现在更高的温度。峰的幅度可以直接用于计算陷阱浓度。
 图5 对应图4中数据的阿伦尼乌斯图。实线为测量数据,虚线为陷阱库中的对比数据,用于缺陷识别。
图5 对应图4中数据的阿伦尼乌斯图。实线为测量数据,虚线为陷阱库中的对比数据,用于缺陷识别。
将不同速率窗对应的峰值温度和发射率绘制在阿伦尼乌斯图(如图5)上,从拟合直线的斜率可以精确得到陷阱的激活能(本例中为340 meV),从其在1000/T→0的截距则可外推出捕获截面。
DLTS技术的最大优势在于其惊人的灵敏度,可以检测到 NT/ND 低至 10-6 的相对浓度,绝对浓度可探测至 < 1010 cm-3,这比晶体原子浓度低了13个数量级,是其他物理分析方法难以企及的。它为每种深能级缺陷提供了独特的“指纹”(激活能和捕获截面),通过与已知的缺陷数据库比对,可以推断缺陷的来源。如果不同陷阱的谱峰发生重叠,还可以通过高斯拟合等数学方法进行分离和解析。因此,要获得一张信噪比高、结果可靠的图谱,对样品制备、设备参数配置都有极高要求。这正是专业检测实验室的核心价值所在。
精工博研测试技术(河南)有限公司(原郑州三磨所国家磨料磨具质量检验检测中心),央企,国字头检测机构,专业的权威第三方检测机构,专业检测半导体深能级,可靠准确。欢迎沟通交流,电话19939716636
在分析台面二极管或平面pn结时,器件表面或边缘的额外漏电流是一个常见的干扰项。这种由表面复合引起的电流会掩盖我们真正关心的体电流特性。表面复合的强度由表面复合速度 S0 (cm/s) 来描述。 $$ j_s = -qS_0 /Delta n /tag{5} $$ 其中 Δn 是载流子偏离平衡值的浓度。S0 本身又与表面态的浓度 Nst (cm-2) 和捕获截面 σ0 (cm2) 相关: $$ S_0 = /sigma_0 v_{th} N_{st} /tag{6} $$ 在进行I-V特性分析(如提取肖特基势垒、理想因子、SRH陷阱参数或分析隧穿、碰撞电离等反向电流机制)之前,必须首先确认测得的电流究竟是体主导还是面主导。
 图6 通过测试二极管的电流-直径双对数图来区分体电流与表面电流
图6 通过测试二极管的电流-直径双对数图来区分体电流与表面电流
一个简单有效的方法是绘制电流与器件直径的双对数关系图(如图6)。
只有在确认了体传导占主导地位后,后续基于I-V曲线的参数提取和机理分析才具有物理意义。


 首页
首页
 检测领域
检测领域
 服务项目
服务项目
 咨询报价
咨询报价